I/O数
元件尺寸
焊料球/焊料柱
图2-2描述了一些新的面积阵列元件,这些元件要求采用微孔工艺实现信号的有效传输。左侧是384个引脚焊料球、0.8mm间距的uBGA器件,右侧是1247个引脚焊料柱、1.0mm间距的CCGA(Ceramic Column Grid Array)器件。

Fig2-2 具有更高I/O数和更精细间距的新型BGA
2.3 基材的考虑
高性能多层板的基材特性是首要考虑的因素。下述黑体部分的5个基材特性与其它设计因素相互影响。
板厚
介电常数(Dk)
耗散因素(Dj)/介质损耗角
线性热膨胀系数(CTE)
玻璃转变温度(Tg)
介电常数(Dk)和耗散因素是影响电气性能最主要的两个特性。从图2-3可知,许多不含环氧材料的树脂可被采用,也可使用多种类型的增强纤维材料(包括不含增强材料的背胶铜箔(RCF―Resin Coated Foil))。前述的两个因素的结合决定了基材的介电性能,树脂也有典型的玻璃转变温度――Tg值。图2-4列举了一些典型的高性能材料。

Fig2-3 不同类别的新型介电质与高性能树脂和增强材料比较

Fig2-4 应用于有机基板的不同类型的树脂纤维电气性能一览表
2.4 叠层的考虑
板的叠层和设计规则的不确定性对印制电路板生产商有一定的影响,这就要求控制在生产商的生产能力范围内否则设计目标无法达到。如下因素至关重要:
板厚
VIP工艺
设计规则
过孔结构
突破模式
采用微孔工艺的VIP技术很容易达到8mil(0.2mm)的焊盘,要比埋孔大一些。图2-5说明了该情况下的设计规则,即信号层和设计规则所确定的传输线路的容量要比元件和电路要求的传输线路的容量大。
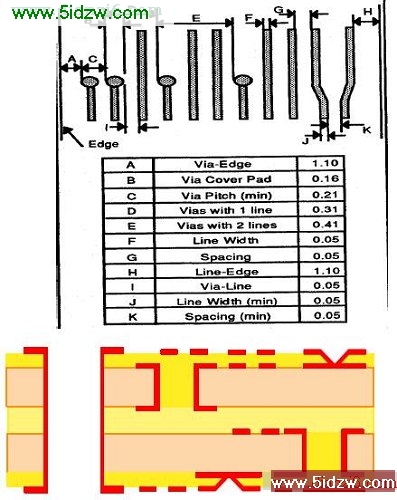
Fig 2-5 线路容量图示
现实中有许多预测线路需求的模型,下面提供了八类常用的模型:
HP''s Design Dense Index
Toshiba Technology Map
Equivalent Ics Per Square Inch
Coors,Anderson & Seward''s Statistical Wiring Length Technique
Rent''s Rule Techniques
Section Crossing Technique
Geometric Approach
Seraphim Wiring Factor
根据线路需求的评估,不同线路的容量是可以预测的,设计规则和叠层结构则决定了这个容量。下表为当前产业界的能力:
特点
传统PCB
传统HP-HDI
PBGA/MCML HDI
高I/O的倒装芯片
最小线宽(mil)
4
5
3
1.6
最小线距(mil)
4
5
3
2.0
最小焊盘间距(mil)
14
20
10
9.3
焊盘最小直径(mil)
20
12-14
12
4-5
过孔形成方法
机械钻孔
光致成孔/激光成孔
光致/激光/等离子成孔
多束激光成孔
最小过孔直径(mil)
10
4-6
3-7
2.5-3.5
焊盘表面处理
SOS Bumps
所有
Ni-Au
Microbumps
目前产业界生产能力比较
图 2-6 描述了最常见的HDI结构,这六种结构遵循了最新的IPC-2315规范,最前面的四类使用频率最高。

Fig2-6 高性能HDI多层板中最常见结构
2.5 组装过程的考虑
设计中需要考虑的最后一个因素就是组装工艺,如下四个必要的设计特点需要考虑进去:
在线测试性
SMT组装间距
板面大小(关系到印刷焊料钢板大小)
返修
如果采用了VIP工艺,那么在线测试的可行性则成为最主要的挑战。这是因为对大的面积阵列元件,VIP技术无法使用突破模式,而是直接嵌入到板内,所以添加测试盘必须考虑到不能损害信号完整性,同时由于X-Y向的热膨胀系数的改变,所以也要注意组装后的板面尺寸变化。如果板面尺寸较大并且印刷焊料的钢板工作片的参考数据点是以一个拐角为基准的,那么在径向每一线性英寸的改变将会使板面尺寸与其它拐角产生0.4英寸的偏差;对一片12inch×16inch板而言,在它较远的拐角则可能产生高达5―7mil的偏差。如果采用了细间距的uBGA,这将是焊接不良的主要原因,对这类器件而言是无法返修的。
要想返修比较可行,基材特性显得尤为重要,在拆卸元件、重焊焊盘以及重新安装新器件的时候,基材要能经受住集中的热冲击还不能导致剥离。
3. 结论
高性能HDI类产品是复杂元件的载体,这类产品具有如下特点:有高的I/O数、更精细的间距、电路的运行频率极高和信号上升时间很快。这样就对信号完整性要求非常严格,自然的也对基材要求严格,过孔结构、叠层方案、设计规则的选择更加复杂。
通过图3-1可以了解所有这些驱动力的优点,该图显示的是一个12层HDI的第一类多层板,该板中有四层具有埋孔,第一到第五层有盲孔。该板就用于连接六片有1247个I/O 陶瓷焊料柱的阵列器件(1.0mm 的间距),与该板具有等效功能的通孔多层板的层数则会高达24层,对连接系统而言,这样的厚度太厚,而且还将导致过多的噪声和信号损失等不良后果。

Fig3-1 12 层HDI高性能多层板图例
编辑:(tanjunrong)
,高速HDI电路板设计过程的考虑(推荐)